专业订制化服务
订制各种规格的石英晶振片
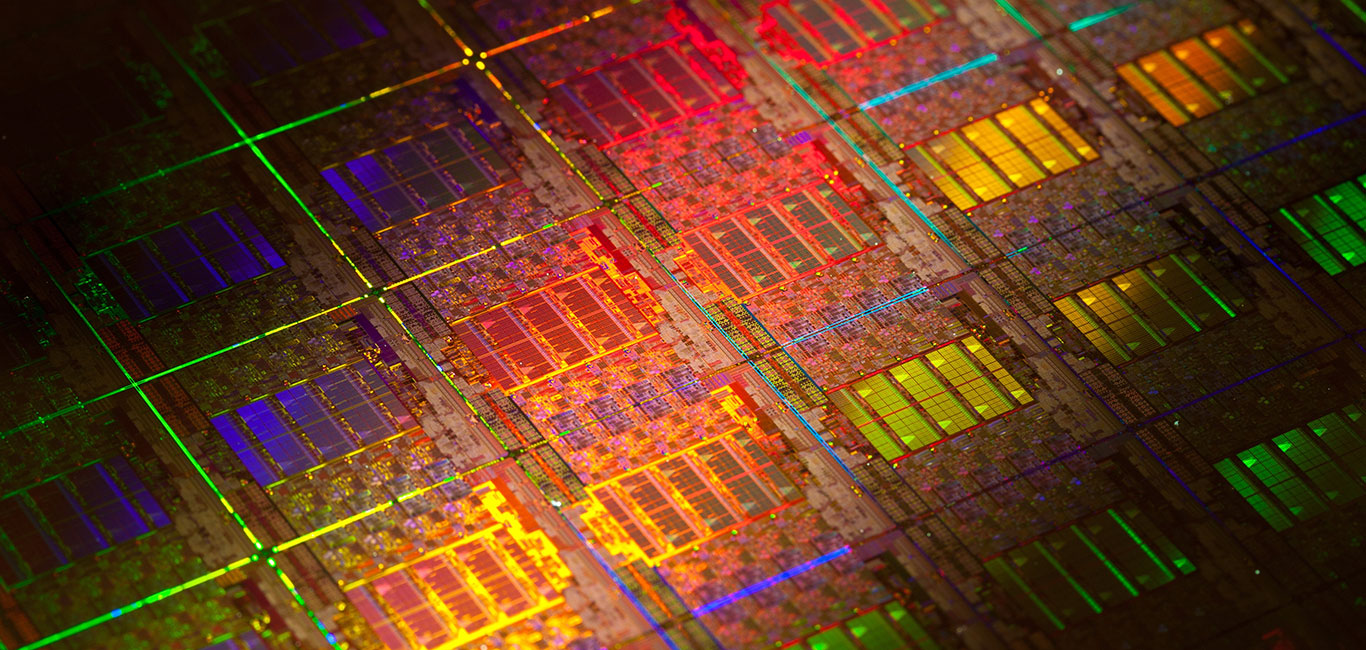

晶圆片总厚度约625μm-775μm,薄膜电路层的有效厚度约20-30μm,因此,至少90%的衬底在芯片封装时是冗余的或有缺陷的。实施晶圆背面减薄,不仅能有效改善划片封装环节的效率和良率,更为重要的是能显著降低芯片的热阻,大幅提升芯片的机械性能和电气性能。
大部分的器件,Fab厂进行正面电路器件植入后,晶圆将依需要进行背面研磨减薄、酸碱法蚀刻,然后在背面蒸镀金属膜层。处理后的芯片器件热阻、工作散热和冷却、封装操作等实现很大的改善。
采用电子束和热阻蒸发,提供真空蒸镀金属、合金薄膜服务。
金属单质:钛、镍、银、金、铬、铝、铂金、钒等。
合金材料:锡铜、锡锑、金锗、金砷等。
依据器件的应用场景要求,以及客户的设计工艺要求,可以提供不同厚度膜系的真空积淀服务。单层膜系
如:Au、Ag。单层膜系
如:Au、Ag。双层膜系
如:锡-金等。三层膜系
如:钛-镍-银。四层膜系
如:钛-镍-锡-银。多层膜系(共晶)。
专门的可靠性试验,牢牢控制薄膜附着力指标,确保合符质量标准要求!


通常在一张晶圆片上有成千上万颗晶粒( die),他们由划片街区连接在一起。一般采用高速旋转的金刚石切割刀片,将每一个具有独立电气性能的晶粒分离出来,他是芯片后续封装的准备。良好的设备性能和切割技术是减少晶粒崩边、分层和剥离的要件,也是芯片信赖性的基础保障。
提供晶圆背面减薄、背面金属化、切割划片一体化服务,一站式服务。为您降低产品过程流转风险,节省外协作业时间
快速、可靠、省时、省力。
•晶圆背面研磨+抛光
•晶圆背面研磨+切割划片
•晶圆背面研磨+背面金属化+切割划片
•晶圆背面金属化+切割划片
